PRODUCTS
KRI社イオンソース
KRI社イオンソース
装置概要
Dr. Kaufman開発
クリーニングから成膜までを支えるKRI社製イオンソース
Dr. Kaufman開発の米国KRI社製イオンソースを販売・取り付けいたします。クリーニング、スパッタ、エッチング等、幅広い用途に適応します。

カウフマン型イオン源、そしてハロルド・カウフマン博士
当社のイオンビーム関連装置の核となる技術は、カウフマン型イオン源であり、その分野で大きな影響力を持つのが、創設者のハロルド・カウフマン博士です。
ハロルド・カウフマン博士
カウフマン博士はNASA勤務時代の研究を基にカウフマン型ブロードイオン源を開発し、航空宇宙のみならず、広く、電気・電子の分野においてもイオンビームエッチング、イオンビームスパッタのイオン源として使用されるようになりました。

- 1971年コロラド州立大学で博士号を取得
- 1978年から退職までコロラド州立大学物理学部長を務める
- 1978年に大学を退職し、Kaufman & Robinson, Inc. を設立

カウフマン博士は2016年にNASAグレン研究センターの殿堂入りを果たしました。NASAはKRI®の創設者をイオン推進の先駆者として称え、「試験で実証されただけでなく、現在も宇宙で使用されている実験的な宇宙飛行用ハードウェアシステムを発明したという、稀有な功績を持つ人物」として紹介されています。
イオンソースの種類と特長
KRI社のイオンソースは、用途と要求されるプロセス環境に応じて選択できます。
エンドホールタイプイオンソース

| 用途 | IADプロセス、プレクリーニング等の超高圧大電流イオンビームプロセスに最適。ダメージの少ないエッチング、クリーニング、イオンアシスト蒸着が可能。 |
|---|---|
| 特長 | 大電流アシスト効果により光学特性が向上。HCES使用で酸素ビームアシスト長時間照射が可能。水冷機構により低温成膜プロセスに対応し、既存装置へ後付け導入も容易。 |
| 導入分野 | 光学分野、レーザー端面、光通信用フィルター、量子デバイス。 |
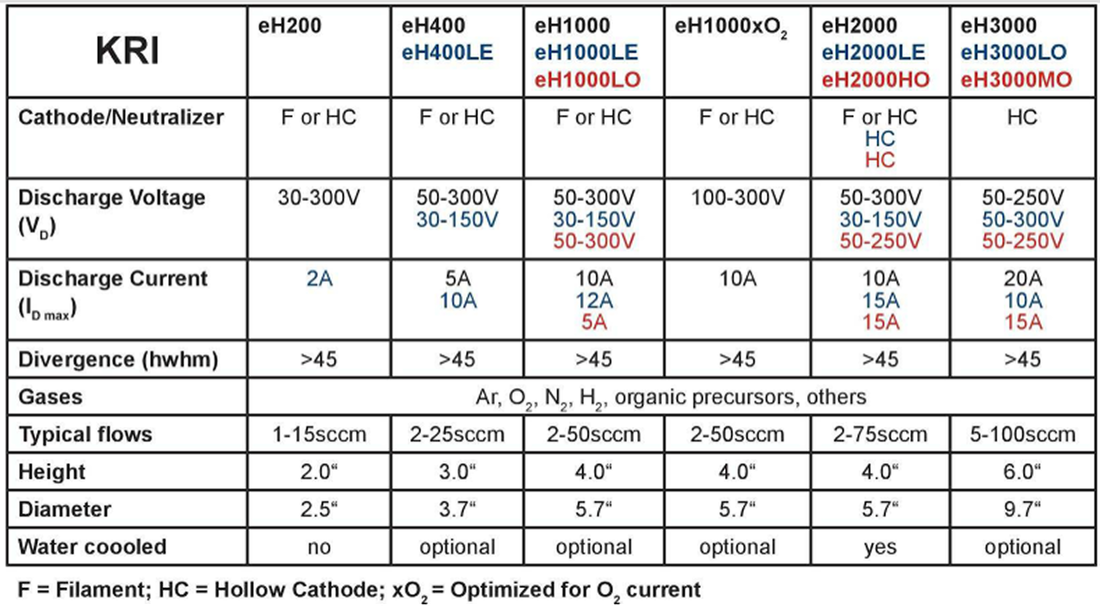
グリッドタイプイオンソース

| 用途 | エッチング、スパッタリング、プレクリーニング用途に使用。高品質光学膜成膜や、磁性材料・金属膜などのエッチング(ミリング)に利用。 |
|---|---|
| 特長 | イオンソース内にプラズマを封じ込めるため、低コンタミ、高動作真空度10-2Pa台を実現。プラズマ放電方式はDCまたはRFから選択可能。 |
グリッドタイプ RFイオンソース
| モデル | RFICP40 | RFICP100 | RFICP140 | RFICP220 | RFICP380 |
|---|---|---|---|---|---|
| ビーム電流 mA | >100 | >350 | >600 | >800 | >1,000 |
| ビーム電圧 V | 100~1200 | 100~1200 | 100~1200 | 100~1200 | 100~1200 |
| ビーム出力径 | 4cmφ | 10cmφ | 14cmφ | 20cmφ | 38cmφ |
| 長さ cm | 12.7 | 23.5 | 24.6 | 30 | 39 |
| 外径 cm | 13.5 | 19.1 | 24.6 | 41 | 59 |
| 取付フランジ | 8″CF | 10″CF | 12″CF | 12″CF | 12″CF |
グリッドタイプ DCイオンソース
| モデル | KDC10 | KDC40 | KDC75 | KDC100 | KDC160 |
|---|---|---|---|---|---|
| ビーム電流 mA | >10 | >100 | >250 | >400 | >650 |
| ビーム電圧 V | 100~1200 | 100~1200 | 100~1200 | 100~1200 | 100~1200 |
| ビーム出力径 | 1cmφ | 4cmφ | 8cmφ | 12cmφ | 16cmφ |
| 長さ cm | 11.5 | 17.1 | 20.1 | 23.5 | 25.2 |
| 外径 cm | 4 | 9 | 14 | 19.4 | 23.2 |
| 取付フランジ | 2-3/4″CF | 6″CF | 8″ or 10″CF | 10″ or 12″CF | 12″CF |

KRI社DC電源
DC電源

| 性能 | ・パルスDC用3000W電源 ・0~1000V、最大10A |
|---|---|
| 特長 | ・100ns未満のアーク検出、1usの緩和時間 ・最大150Vまで調整可能な逆電圧 ・可変動作周波数・超低アークエネルギー |
非パルスDC電源

| 性能 | ・パルスDC用最大1500W電源 ・0~1000V、最大4A |
|---|---|
| 特長 | ・200ns未満のアーク検出、1usの緩和時間 ・優れたアーク検出性能 ・超低アークエネルギー |
エレクトロンソース(電子銃)
イオンビームプロセスを補完するエレクトロンソース(電子銃)を提供しています。
この装置は、電子放出を目的としています。
エレクトロンソース

| 性能・導入分野 | ・イオンエンジン開発 ・MPDスラスタ開発 ・各種イオンソースに取付 |
|---|---|
| タイプ | ・ホロカソードタイプ ・フィラメント内蔵タイプ ・RFタイプ |
| Product | SHC1000 (selective uses) |
MHC1000 | LHC1000 | LFN2000 |
|---|---|---|---|---|
| Type | Hollow cathode | Hollow cathode | Hollow cathode | Low AC Frequency |
| Plasma coupling | Yes | Yes | Yes | Yes |
| IE max | 5A | 10A | 20A | 1A |
| VB | < 50eV | < 50eV | < 50eV | < 50eV |
| Insert life* | 100 to 500 hrs | 200 to 800 hrs | 200 to 1000 hrs | 200 to 600 hrs |
| Typical flows (Ar) | 5-10sccm | 5-10sccm | 5-20sccm | 4-6sccm |
| Width | 1.51” | 2.3” | 2.3” | 2.3” |
| Length | 2.85” | 3.6” | 4.6” | 1.65” |
| Mounting | Internal remote | Internal remote | Internal remote | Internal remote |
| Installations | eH, RFICP, KDC, anode layer, cathodes, thrusters | eH, RFICP, KDC, anode layer, cathodes, thrusters | eH, RFICP, KDC, anode layer, cathodes, thrusters | RFICP, KDC, anode layer, cathodes |
| Process | Etch, Deposition, Space | Etch, Deposition, Space | Etch, Deposition, Space | Etch, Deposition |
*Process Pressure: 2~4 x 10-2Pa
RFニュート
ラライザー
RFN3000

| 出力 | 2.5A 酸素ビーム環境対応 |
|---|