PRODUCTS
イオンビームスパッタ装置
イオンビームスパッタ装置
装置概要
高密度・低不純物成膜を実現するIBS装置
本装置は、RFイオンソースを使用し、シングルステージ又はプラネタリーステージを搭載したイオンビームスパッタリング(IBS)装置です。
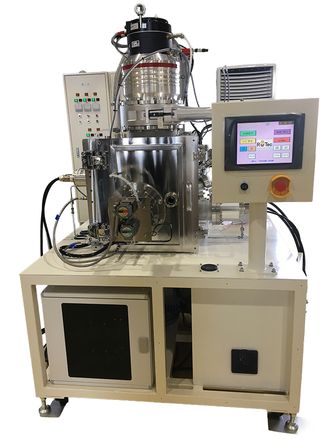
装置の特徴
イオンビームスパッタ装置(IBS装置)
IBS装置は、お客様の高度な成膜ニーズに対応する以下の優れた特徴を持っています。
高品質・高密度な成膜と低温プロセス
高真空成膜
プロセス動作圧は10⁻²Pa台であり、高真空成膜が可能です。この成膜真空度10⁻²Pa台のため、蒸着や通常スパッタ装置よりも不純物が少なく、緻密な成膜を実現します。
高品質
コンタミネーションが少ないクリアな成膜環境。高密度膜の成膜が可能です。
低温プロセス
成膜温度100度以下の無加熱成膜が可能です。
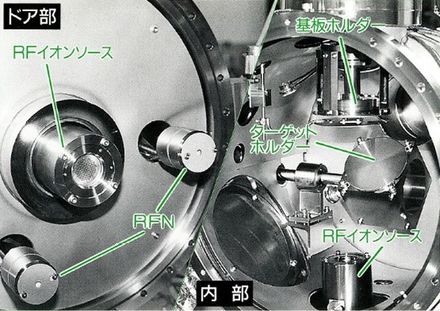
多様な材料への対応と膜質制御
材料対応
スパッタイオンソースとアシストイオンソースにより、酸化物/窒化物成膜に対応します。
膜質制御
アシストビームにより膜応力調整が可能です。
多面ターゲットにも対応。
膜厚制御性が良好です。
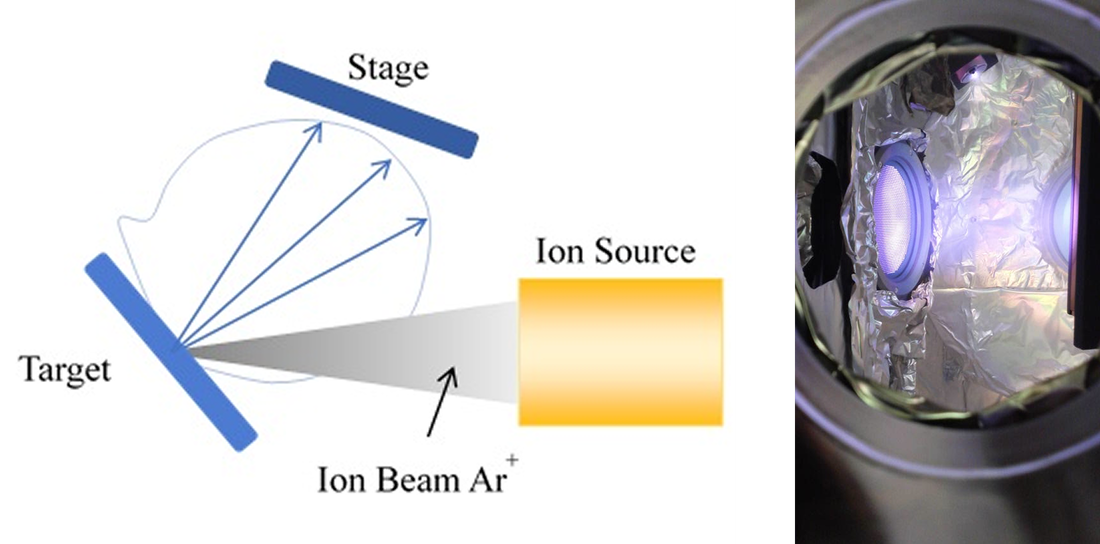
カスタム設計とモニタリング
カスタム設計
基板サイズ/枚数に応じたチャンバー設計に対応します。
膜厚計
透過型光学モニターおよび水晶膜厚計を搭載可能です。
その他の特徴
反応性成膜や、イオンビームアシスト(追加)成膜に対応します。
精度の高い膜厚制御が可能です。
光学用イオンビームスパッタ装置(光学用IBS装置)
この装置は、通常のイオンビームスパッタ装置(IBS装置)の機能に加え、特に光学薄膜の成膜精度を高めたラインナップです。
主な特徴と機能
波長範囲
可視域~赤外域用成膜装置
透過型膜厚計によるその場測定を成膜ソフトに反映し、任意透過率で制御
成膜真空度10-2Pa台
蒸着や通常スパッタ装置よりも不純物が少なく、緻密な光学薄膜成膜が可能
RFイオンソースによる酸化物多層膜成膜に対応
アシストイオンビームにより酸化促進と応力調整が可能
波長可変レーザ透過型膜厚計によるその場膜厚測定が可能
低成膜レートによる良好な膜厚制御が可能
波長可変レーザ透過型膜厚計からの分光データをもとに、吉川トレーディング成膜ソフトでは任意透過率制御可能
Macleodデザインデータを成膜ソフトに読み込み、成膜を行えます。
成膜制御方法
極値、任意透過率、時間・自動成膜は、シーケンサ/イオンソース出力/光学式膜厚計を制御し、真空引き/自動成膜/透過スペクトル測定の一連のプロセスを行う。

用途・導入分野
用途
可視域から赤外域の光学薄膜多層成膜
導入分野
光学分野、レーザー端面、光通信用フィルター、量子デバイス